Введение
Оптическая литография объединяет в себе такие области науки, как оптика, механика и фотохимия. При любом типе печати ухудшается резкость края (рис. 1). Проецирование двумерного рисунка схемы ведет к уменьшению крутизны края, поэтому нужен специальный резист, в котором под воздействием синусоидально модулированной интенсивности пучка будет формироваться прямоугольная маска для последующего переноса изображения травлением. Если две щели размещены на некотором расстоянии друг от друга, то неэкспонируемый участок частично экспонируется по следующим причинам:
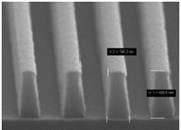 1) дифракция;
1) дифракция;
2) глубина фокуса объектива;
3) низкоконтрастный резист;
4) стоячие волны (отражение от подложки);
5) преломление света в резисте.

Таким образом, задача фотолитографии заключается в том, чтобы обеспечить совмещение и воспроизвести в резисте двумерный рисунок фотошаблона с точностью в пределах ±15% от номинального размера его элементов и с 5%-ным допуском на требуемый наклон краев. Послойное совмещение приборных структур должно осуществляться с точностью не хуже ±25% от размера минимального элемента. Используемые в фотолитографии источники экспонирующего излучения бывают как точечными (лазеры), так и протяженными (ртутные лампы). Спектр излучения этих источников лежит в трех основных спектральных диапазонах: Дальний УФ от 100 до 200-300 нм;
Средний УФ 300-360 нм; Ближний УФ от 360-450.
