Уважаемый преподаватель курсовая скачена из интернета и студентом даже не прочитана
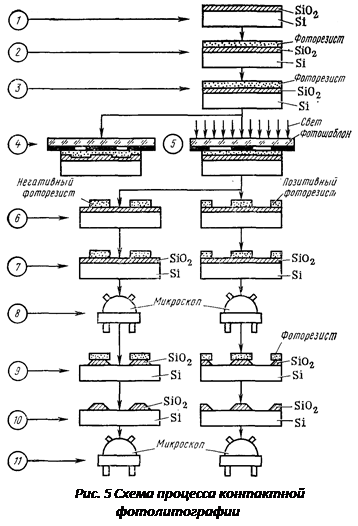 Процесс контактной фотолитографии состоит из ряда пунктов представленных на рисунке 5.
Процесс контактной фотолитографии состоит из ряда пунктов представленных на рисунке 5.
1. подготовка поверхности исходной подложки;
2. нанесение на подложку слоя фоторезиста;
3. первая сушка фоторезиста — пленкообразование;
4. совмещение рисунка фотошаблона с рисунком на исходной подложке (если процесс фотолитографии повторяется с изменением; фотошаблона);
5. экспонирование фоторезиста контактным способом;
6. проявление фоторезиста;
7. вторая сушка фоторезиста — полимеризация;
8. контроль рельефа рисунка в пленке фоторезиста;
9. травление подложки;
10. снятие пленки фоторезиста с поверхности подложки;
11. контроль рельефа рисунка в подложке.
1. Начинаем процесс с очистки поверхности пластин от загрязнений способных влиять на структуру фоторезиста:
молекулярные загрязнения – органические (масла, жиры, остатки фоторезиста, растворителей и др.), механические (пыль, абразивные частицы, ворсинки) и плёнки химических соединений (окислы, сульфиды, нитриды и др.);
ионные загрязнения – соли, основания и кислоты из остатков травильных растворов, химически связанные с поверхностью пластины;
атомарные загрязнения – атомы тяжёлых металлов, Ag, Cu, Fe, осевшие на поверхность пластины из химических реактивов в виде микрозародышей. Химическую очистку от загрязнений осуществляют путём обработки в органических растворителях, кислотах и деионизованной воде. Альтернативой органическим растворителям являются перекисно-аммиачные смеси, перекись водорода окисляет органические загрязнения и переводит их в растворимое состояние. Качество такой отмывки выше ещё и потому, что водные растворы аммиака способны к комплексообразованию с ионами меди, серебра и др.
Процесс отмывки полупроводниковых пластин деионизованной водой ведем, в аппарате OSTEC ADT 976 постоянно измеряя электрическое сопротивление воды. По мере снижения концентрации примесей сопротивление воды постепенно повышается. При установлении постоянного сопротивления воды процесс отмывки считаем законченным.
1.1 Качество отмывки определяем в темном поле микроскопа Nikon Eclipse L200А при увеличении в 300х по числу светящихся точек.
2. Нанесение фоторезиста
Наибольшее распространение получило центрифугирование, позволяющее использовать несложные устройства с центрифугой. Толщина плёнки фоторезиста зависит от вязкости, времени нанесения, скорости вращения центрифуги, температуры и влажности среды. Плёнка фоторезиста должна быть равномерна (не хуже ±10%) по толщине и иметь хорошую адгезию к подложке. Последнего добиваются путём предварительного отжига пластин при различных температурах в зависимости от материала покрытия: SiO2 - 900-10000С в атмосфере кислорода, примесносиликатное стекло – 5000С в атмосфере кислорода, Al – отжиг в аргоне при 3000С.
Применение пульверизации для нанесения фоторезиста позволяет автоматизировать процесс, однако связано с большим расходом материала и более сложным контролем за толщиной покрытия. Метод окунания применяют редко, так как, несмотря на простоту и возможность ручного исполнения он не даёт воспроизводимых результатов.
После очистки наносим на пластину слой позитивного фоторезиста фп - 383 толщиной 1.0 мкм. отфильтрованного и разбавленного до степени вязкости (6.0 cCm). Нанесение фоторезиста производим методом центрифугирования в аппарате OSTEC EVG®101, наносим 6-10 капель фоторезиста в центр пластины и распределяем по поверхности при скорости вращения центрифуги 3800 об./мин в течение 30 сек.
3. Первая сушка
Назначение первой сушки фоторезиста состоит в удалении растворителя, уплотнения и уменьшения внутренних напряжений в плёнке, что улучшает адгезию фоторезиста к подложке. Используют три метода сушки: конвективная, ИК-сушка – нагрев от лампы или спирали, и СВЧ - сушка – нагрев за счёт поглощения энергии СВЧ - поля. Последние два метода предпочтительны, так как осуществляют нагрев от подложки и, тем самым, обеспечивают полное удаление растворителя.
После обработки на центрифуге фоторезист сушим: в таре при температуре 20 оС в течение 20 мин; в сушильном шкафу Sawatec HP 150 при температуре 97 оС в течение 30 мин; в таре при температуре 20 оС в течение 35 мин.
4. Совмещение пластины с фотошаблоном.
В процессе изготовления кристалла ИМС фотолитография повторяется многократно, и необходимо каждый раз осуществлять совмещение рисунков топологии кристалла ИМС. Для совмещения используют сложные оптико-механические комплексы, позволяющие осуществлять совмещение визуально, вручную и автоматически. В первом случае сначала проводят совмещение строк и столбцов (так называемое грубо совмещение), а затем точное совмещение по реперным знакам с точностью в пределах 1 мкм. Автоматизированный способ совмещения обеспечивает точность совмещения до 0,1 мкм. Оптическая система обеспечивает обзор при увеличении 40-80х и точное совмещение при 100-400х
